人工智能加速先進(jìn)封裝中的熱機(jī)械仿真
為了實(shí)現(xiàn)更緊湊和集成的封裝,封裝工藝中正在積極開發(fā)先進(jìn)的芯片設(shè)計、材料和制造技術(shù)。隨著具有不同材料特....

一文詳解3D光電互連技術(shù)
人工智能和機(jī)器學(xué)習(xí)應(yīng)用的爆炸式增長已經(jīng)將高性能計算系統(tǒng)推向極限。在訓(xùn)練日益復(fù)雜的AI模型時,計算需求....
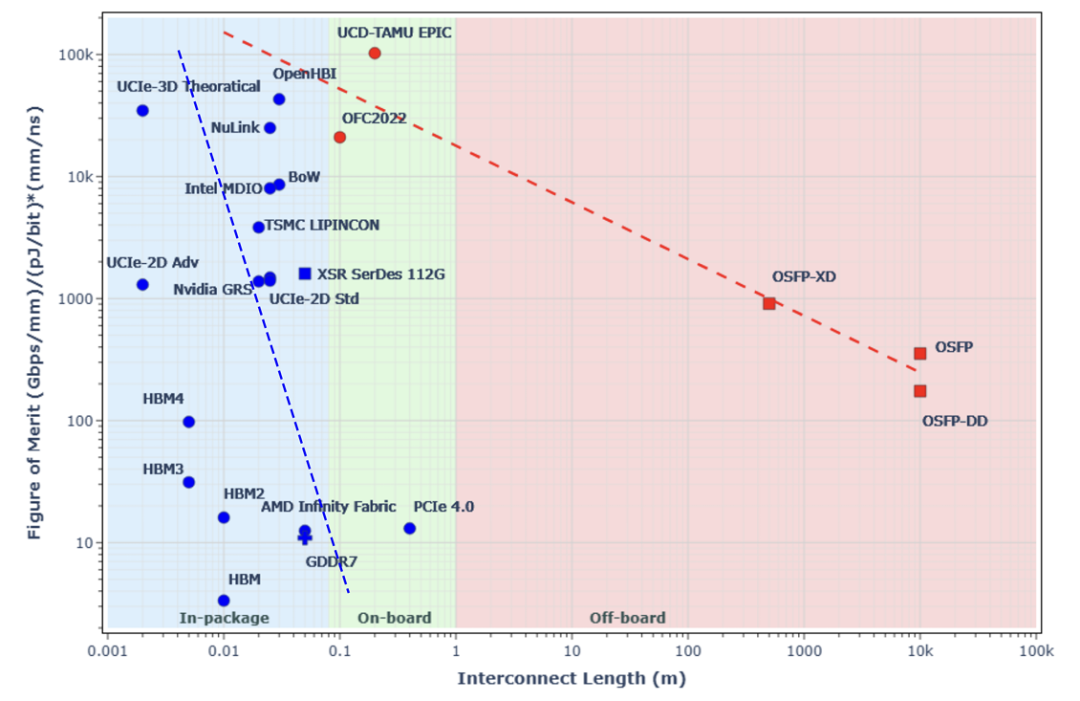
臺積電CoWoS平臺微通道芯片封裝液冷技術(shù)的演進(jìn)路線
臺積電在先進(jìn)封裝技術(shù),特別是CoWoS(Chip on Wafer on Substrate)平臺上....

Chiplet與異構(gòu)集成的先進(jìn)基板技術(shù)
半導(dǎo)體產(chǎn)業(yè)正處在傳統(tǒng)封裝邊界逐步消解的轉(zhuǎn)型節(jié)點(diǎn),新的集成范式正在涌現(xiàn)。理解從分立元件到復(fù)雜異構(gòu)集成的....

玻璃基板技術(shù)的現(xiàn)狀和優(yōu)勢
玻璃基板正在改變半導(dǎo)體封裝產(chǎn)業(yè),通過提供優(yōu)異的電氣和機(jī)械性能來滿足人工智能和高性能計算應(yīng)用不斷增長的....

玻璃中介板技術(shù)的結(jié)構(gòu)和性能優(yōu)勢
半導(dǎo)體行業(yè)持續(xù)推進(jìn)性能和集成度的邊界,Chiplet技術(shù)作為克服傳統(tǒng)單片設(shè)計局限性的解決方案正在興起....
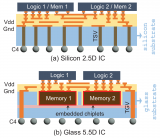
用于高性能半導(dǎo)體封裝的玻璃通孔技術(shù)
半導(dǎo)體行業(yè)正在經(jīng)歷向更緊湊、更高效封裝解決方案的轉(zhuǎn)型。隨著移動設(shè)備和物聯(lián)網(wǎng)(IoT)應(yīng)用對更小、更薄....

光電共封裝技術(shù)的實(shí)現(xiàn)方案
數(shù)據(jù)中心網(wǎng)絡(luò)架構(gòu)正在經(jīng)歷向光電共封裝(CPO)交換機(jī)的根本性轉(zhuǎn)變,這種轉(zhuǎn)變主要由其顯著的功耗效率優(yōu)勢....
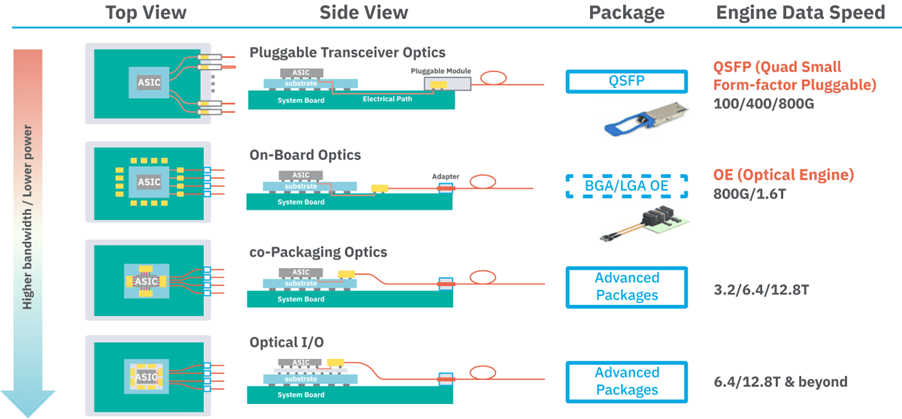
先進(jìn)Interposer與基板技術(shù)解析
傳統(tǒng)封裝方法已無法滿足人工智能、高性能計算和下一代通信技術(shù)的需求。晶體管尺寸已縮小至個位數(shù)納米量級,....
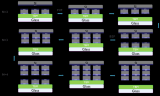
FOPLP工藝面臨的挑戰(zhàn)
FOPLP 技術(shù)目前仍面臨諸多挑戰(zhàn),包括:芯片偏移、面板翹曲、RDL工藝能力、配套設(shè)備和材料、市場應(yīng)....

基于硅基異構(gòu)集成的BGA互連可靠性研究
在異構(gòu)集成組件中,互連結(jié)構(gòu)通常是薄弱處,在經(jīng)過溫度循環(huán)、振動等載荷后,互連結(jié)構(gòu)因熱、機(jī)械疲勞而斷裂是....

基于板級封裝的異構(gòu)集成詳解
基于板級封裝的異構(gòu)集成作為彌合微電子與應(yīng)用差距的關(guān)鍵方法,結(jié)合“延續(xù)摩爾”與“超越摩爾”理念,通過S....

陶瓷金屬多層材料毫米激光微孔加工的熱力耦合模型研究
提高激光強(qiáng)度(激光功率密度)可以有效提高微孔的加工速 率。然而,過高的激光強(qiáng)度在加工過程中也會造成過....

半導(dǎo)體中載流子的運(yùn)動
半導(dǎo)體中電子和空穴運(yùn)動方式有很多種,比如熱運(yùn)動引起的布朗運(yùn)動、電場作用下的漂移運(yùn)動和由濃度梯度引起的....

多芯粒2.5D/3D集成技術(shù)研究現(xiàn)狀
面向高性能計算機(jī)、人工智能、無人系統(tǒng)對電子芯片高性能、高集成度的需求,以 2.5D、3D 集成技術(shù)為....

芯片制造中的化學(xué)鍍技術(shù)研究進(jìn)展
芯片制造中大量使用物理氣相沉積、化學(xué)氣相沉積、電鍍、熱壓鍵合等技術(shù)來實(shí)現(xiàn)芯片導(dǎo)電互連。